电子技术论坛
信息来源: 时间:2021-12-13
栅极绝缘物内的离子电导对MOS器件电特性的影响
如在2.2.3节所阐明的,栅极绝缘物内一定数量的电荷对MOS器件电特性的影响在很大程度上依赖于电荷相对于硅-二氧化硅界面的空间分布。特别是,位于紧靠界面的电荷将在硅表面附近感生数值相等符号相反的电荷,从而对器件的阈电压或平带电压产生很大的影响。而栅电极附近的电荷对硅表面乃至实测的电特性没有多少影响。因此,假如位于栅极绝缘物内的离子电荷在强电场作用下可以自由运动,则在应用恒定直流栅极偏压时,将观测到器件电特性有相当大的变化,这种变化是时间的函数。
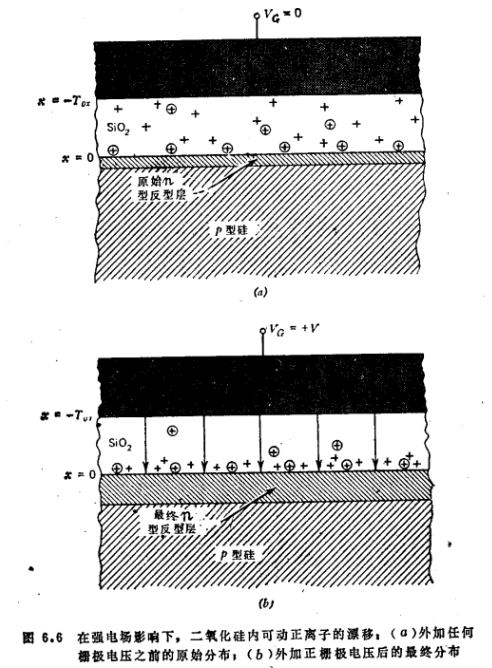
二氧化硅绝缘层内的氢离子特别是钠离子在强电场影响下显示出相当大的迁移能力,由此产生的电荷运动会导致有害的不稳定性和器件临界参数的漂移。虽然上述正离子在二氧化硅内的迁移率相当小,但是由于在典型的工作条件下存在着极高的电场强度,正离子通过栅极绝缘物的运动也是可观的。例如,对于栅极绝缘物厚度为1000埃的器件,外加栅极偏压为10伏,忽略表面空间电荷层的电压降,结果可在绝缘物内产生高达106伏/厘米的电场强度。参照如图6.6(a)所示的结构,在MOS器件二氧化硅绝缘物内通常具有可动和不可动的两种离子。(图中有圆圈的为不可动离子,以区别于可动离子。)如图6.6(b)所示,应用正栅-衬电势将会在氧化层内形成一个很大的电场,其方向是从栅极排斥可动正离子,而将它们推向硅-二氧化硅界面。当这些离子向界面漂移时,就会在硅表面感应越来越多的负电荷。例如如图6.6结构所示,这种情况可使在制作于中等高电阻率p型衬底的MOS器件中所观察到的表面反型程度增加。假如取表面电导作为时间函数来作图,在外加正栅极电压之后,表面电导立即迅速增加,而当所有可动离子在外加电场影响下漂移到硅-二氧化硅界面之后,最终将会达到饱和状态。如图6.7所示,即使假定栅极电压退回到零,表面电导也不会恢复到其原始值。只有对栅电极施加负电压,将可动正离子从界面拉回到绝缘层体内,表面电导才能恢复其原始值。
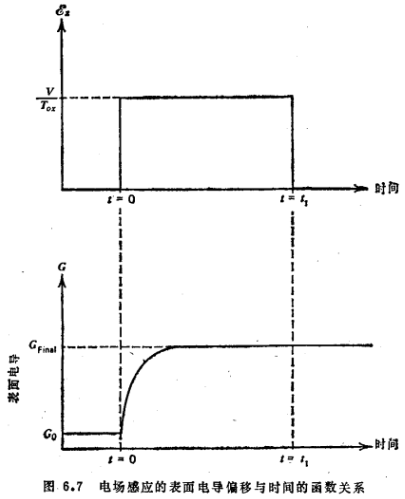
同理,假如可动正电荷位于栅极氧化物内,对制作于n型衬底的MOS电容器施加正栅电压可以增加表面累积。一般来说,假定MOS电容器的栅极氧化层被钠或其它任何类型的可动正离子所污染,外加正向栅-衬电压将会使观测的平带电压向负方向移动,而外加负栅电压则将引起正向移动。
MOS结构栅极绝缘物内的电场感应离子漂移问题可以通过多种途径有效地降到最低程度。最常用的方法是通过采用超净工艺技术,尽量消除栅极绝缘物中的钠离子污染。例如,必须极其仔细地处理炉膛内的石英管壁,而使二氧化硅栅极绝缘物在其中生长时,实际上不受钠的污染。最近克里格勒(Kriegler),程(Cheng),和科尔顿(Colton)20提出的报告说:氯化氢气体和干氧的混合物对于“清洗”石英炉管极为有效。他们还发现,在氧化气体环境中加入很小比例的氯化氢或氯可以大大改善单纯在干氧环境中生长的二氧化硅薄膜的电稳定性。同时又发现这一技术不但可以减少来自炉管的可动离子的污染,而且有助于使由此生长的氧化薄膜钝化,防止后来由于淀积污染金属层所引起的离子不稳定性。
在二氧化硅层生成以后,由于涂复了一层下一道光刻工艺所需要的光致抗蚀剂,氧化物就可能遭到污染。因为大多数的光致抗蚀剂往往被钠严重污染,在光刻完成以后,氧化层必须进行化学清洗并稍加腐蚀,将带有残留污染物的氧化层上部减薄50到150埃。这一步骤对于经过接触式光刻工艺以后而在栅电极金属层淀积之前的栅极氧化物特别重要。然而这种清除工作对于硅栅或钼栅工艺技术并不必要,在这种工艺中,对在栅电极下面部分腐蚀的二氧化硅层来说,栅电极只作为一种掩膜,因为在这样的结构中,光致抗蚀剂与栅极绝缘物没有直接接触。(硅栅和钼栅工艺将在下章详细讨论。)
如上所述,可动正离子之所以可能穿越典型MOS器件的二氧化硅层而徙动,是因为二氧化硅内各种离子的迁移率都足够大,即使在室温下,对于数量级为105到106伏/厘米的电场,也能产生相当可观的漂移速度。(离子的迁移率,亦即对于给定的外加电场的漂移速度,是随温度增加而增加的。然而,虽然离子徙动过程可以在高温下被加速,但是不论平带电压或是阈电压移动的最大值都与温度无关。)正离子徙动所引起的MOS结构不稳定性,可以采用其它方法减到最小,通常是采用某种方法减小栅极介质内各种离子的迁移率。有一种成功地用来减小正离子穿越栅极绝缘物运动的方法,是在热生长二氧化硅栅极绝缘物上生成一层薄薄的磷硅玻璃21。约恩(Yon),柯(Ko)和库珀(Kuper)22应用放射性示踪技术证明,与玻璃层下面的氧化物相比,钠离子更加容易溶解于磷硅玻璃,从而为磷硅玻璃所吸收,于是就阻止了钠离子在外加栅极电场影响下穿越栅极绝缘物。然而,假如采用这个技术,必须注意确保磷硅玻璃的厚度小于余下的二氧化硅的厚度。假如不这样做,就会产生偶极子型极化,从而引起与栅极绝缘物钠污染无关的平带电压或阈电压的移动。虽然在观测正离子徙动情况时,发生的移动与一定极性的栅极电压方向相同,与后一种机理不同,由这种极化引起的最终移动值随外加栅极电压的大小而变。
已经证明氮化硅和氧化铝都是存在高电场时防止钠离子徙动的极为有效的屏障24,25。为了防止钠进入MOS结构的栅极绝缘物,同时又能保持硅及其热生长氧化物之间的界面所具有的十分宝贵的性质,已有许多研究人员采用双层栅极绝缘物来制作器件。这种结构的稳定性和电特性非常好,目前采用SiO2-Si3N4,和SiO2-Al2O3作为栅极介质的大规模集成电路正在大量生产。应用这种双层栅极绝缘物还有一个好处是氮化硅和氧化铝介电常数都比二氧化硅的介电常数大得多。因此,与二氧化硅栅极绝缘层机械厚度相同,由SiO2-Si3N4或SiO2-Al2O3构成的双层绝缘物,在电性质上与较薄的二氧化硅层等效。当然这将使器件可以获得较高的增益系数β,减少阈电压随衬-源电压(源体效应)的变化量。对于p沟道结构,应用上述任何一种双层绝缘物也能使阈电压降低,降低的数值是采用相同机械厚度的二氧化硅作为栅极绝缘物的器件所无法达到的。因此,采用这些技术制成的集成电路,典型的岗电压在-1.5伏到-2.3伏之间,所以允许这些电路与双极型集成电路直接联接。
虽然采用SiO2-Si3N4或SiO2-Al2O3栅极介质制作的MOS结构已经证明实际上可以消除种种正离子漂移穿越栅极绝缘物所引起的偏压不稳定性,但是绝缘层之间不同的电导率会引起绝缘层之间界面上的电荷积累。假如电荷在此界面上积累,就会在硅表面产生极性相反的感应电荷,从而使平带电压和阈电压观测值发生移动。对于给定的电压,如果构成双层栅极电介质的两种材料的相对电导率存在差别,在其中一个绝缘层上就有比另一绝缘层更多的电流通过,而电荷不断地在两绝缘层的界面上积累,直到界面捕获足够的电荷,达到平衡状态为止。结果,因为在界面的电荷积累随时间而变化,所以平带和阈电压移动观测值也将随时间而变。弗尔曼一本茨考夫斯基(Forhman-Bentchkowsky)和福赛恩(Fors ythe)26、27提出的报告中指出:对于采用热生长二氧化硅并覆盖以化学汽相淀积氮化硅层而构成的栅极绝缘物制作的MOS结构,采用比氮化硅层厚的二氧化硅层并淀积电导率很低的氮化物,可以将上述电荷积累影响降低到最小。用这种方法在125℃,外加偏压15伏,工作在100,000小时以上,阈电压移动只有十分之几伏26,27。低电导率的氮化物可在氮化硅层淀积时精确地控制硅烷-氨或硅烷-四氢化硅之间比例而获得,也可以在700到850°C范围的相对低温下淀积氮化物来取得。
尼克(Nigh)、施塔赫(Stach)和雅各布斯(Jacobs)的早期工作表明:采用SiO2-Al2O3,作为器件的双层栅极介质可以取得同样好的稳定性和其它性能。这个结果后来为切尼(Cheney),雅各布斯(Jacobs),科布(Korb),尼克(Nigh)和施塔赫(Stach)所肯定,他们用这种工艺制造出了性能高,可靠的MOS梁式引线集成电路28;同时也为达德利(Dudley)和拉布达(Labuda)所肯定,他们的报告指出,用此方法获得了极其良好的稳定性能。柯里(Curry)和尼克(Nigh)25以及沃尔登(Walden)和斯特兰(Strain)30还观测到,只要工作电压和栅极绝缘物内的电场强度适度地低一些,SiO2-Al2O3结构就有极好的稳定性。
一般来说,增加二氧化硅层厚度和覆盖其上的氧化铝或氯化物层厚度之间的比例,就能改善双层绝缘物MOS结构的稳定性。为了使采用氧化物-氮化物工艺制作的数字集成电路工作稳定,通常采用夹层结构,譬如可以在600埃二氧化硅上覆盖400埃氮化硅层。
值得注意的是,对于厚度约为15到20埃的极薄二氧化硅层覆盖以较厚的氮化硅后的情况,由于电荷直接穿过薄氧化层而被氧化物一氮化物界面上的局部状态所捕获,结果在两个绝缘层的界面上发生相当明显的电荷积累。已经证明在氮化硅及其下面的二氧化硅之间的界面上存在施主型状态或陷阱。当外加较大的负栅电压时,电子被排出陷阱,而穿过极薄的二氧化硅层进入衬底,从而使状态发生改变而带正电。同理,如外加大的正电压,电子就从衬底穿回陷阱。陷阱内的电荷量可能在很大的范围内变化,并因为氧化物-氮化物界面非常接近硅的表面,所以这些电荷对硅的表面电势以及器件阈电压都有相当显著的影响。例如,对于p沟道结构,外加大的负栅电压往往可在氧化物-氮化物界面积累足够的正电荷,使得MOS场效应晶体管的阈电压非常负。随后再外加大的正栅电压将使阈电压改变回到低的负值,器件又显现出原来的特性。目前直接贯穿金属-氮化物-氧化物-硅(MNOS)结构已引起很大的注意,因为这种结构是有电可变阈电压的特性,可以用作非易失电可变半导体电子存储器31-35。
联系方式:邹先生
联系电话:0755-83888366-8022
手机:18123972950
QQ:2880195519
联系地址:深圳市福田区车公庙天安数码城天吉开元游戏官网CD座5C1
请搜微信公众号:“KIA半导体”或扫一扫下图“关注”官方微信公众号
请“关注”官方微信公众号:提供 MOS管 技术帮助




